![]()
Mikroskop AFM Vertex – kanadyjskiej firmy ICSPI Corp. – pierwszy na świecie AFM, który umożliwia pomiar nieskończenie wielkiej próbki. Dzięki wykorzystaniu technologii mikrochipów urządzenie pozwala na niedestrukcyjne analizy w nanoskali dla bardzo dużych próbek. Innowacyjność tego systemu polega na tym, że wystarczy umieścić go na dowolnej powierzchni, dla której chcemy zmierzyć parametry topografii, co eliminuje potrzebę niekiedy skomplikowanej preparatyki próbki.
Aparat posiada zintegrowane moduły łączności bezprzewodowej i daje możliwość pracy na baterii bez konieczności podłączania okablowania. Dzięki temu sprawdza się w każdym miejscu, w którym wymagane są dane 3D w nanoskali bez znaczenia czy jest to skrzydło samolotu, rurociąg naftowy czy reaktor jądrowy, nie pozostawiając po sobie żadnego śladu. Nie wymaga obecności operatora, który może zdalnie sterować urządzeniem z innego miejsca.
Niewielki rozmiar i waga Vertex AFM, wraz z wyjątkową odpornością na wibracje wewnętrzne daje możliwość zastosowania go wszędzie tam, gdzie jest to potrzebne zarówno w terenie, na linii produkcyjnej lub w laboratorium.
Zasada działania urządzenia jest bardzo podobna jak w pionierskim urządzeniu AFM nGauge. Wszystkie potrzebne czujniki i sensory są zintegrowane na chipie o wielkości 1mm x 1mm na końcu którego znajduje się sonda z bardzo małą końcówką przypominającą igłę. Punkt po punkcie igła oddziałuje z powierzchnią i zbiera wyniki uzyskując obraz topografii badanego obszaru.
Zalety mikroskopu AFM Vertex
- Łączność bezprzewodowa
- Praca na baterii
- Brak konieczności preparatyki próbki
Zasada działania mikroskopów sił atomowych (ang. Atomic Force Microscope – AFM) polega na gromadzeniu danych o strukturze powierzchni, poprzez obserwację oddziaływań sondy skanującej określony obszar próbki. Reakcja sondy jest rejestrowana w taki sposób aby była znana wysokość każdego punktu skanowanej powierzchni charakteryzując w ten sposób jej topografię. W mikroskopii sił atomowych do fizycznego kontaktu z powierzchnią używa się sondy z bardzo małą końcówką, przypominającą igłę.
W mikroskopach sił atomowych firmy ICSPI sonda oraz wszystkie czujniki i skanery zostały zintegrowane w pojedynczym chipie o wymiarach 1 mm x 1 mm. Czas trwania pomiaru wynosi od 16 sekund do 20 minut, w zależności od wielkości obszaru skanowania oraz wybranej rozdzielczości.
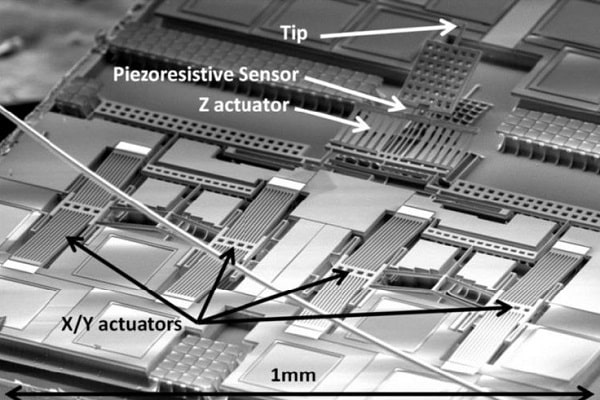
| Skanowanie | |
| Maksymalny obszar skanowania (XYZ) | 20 × 20 x 10 µm |
| Rozdzielczość skanera | <0,5 nm |
| Akwizycja danych – Szybkość skanowania | |
| Szybkie skanowanie (128 x 128 pikseli) | 16 sekund |
| Zwykłe skanowanie (256 x 256 pikseli) | 80 sekund |
| Wysoka rozdzielczość (512 x 512 pikseli) | 5 minut |
| Maksymalna rozdzielczość (1024 x 1024 pikseli) | 20 min |
| Specyfikacje urządzenia | |
| Wymiary urządzenia (dł.×szer.×wys.) | 20mm × 15 mm × 10 mm |
| Połączenie bezprzewodowe | WIFI 802.11n, Bluetooth 5 |
| Bateria | 12,000 mWh |
| Zasilanie | 110-240 V |
- Inżynieria materiałowa,
- Elektrotechnika,
- Polimery,
- Nanotechnologia.
Linki do strony producenta



